
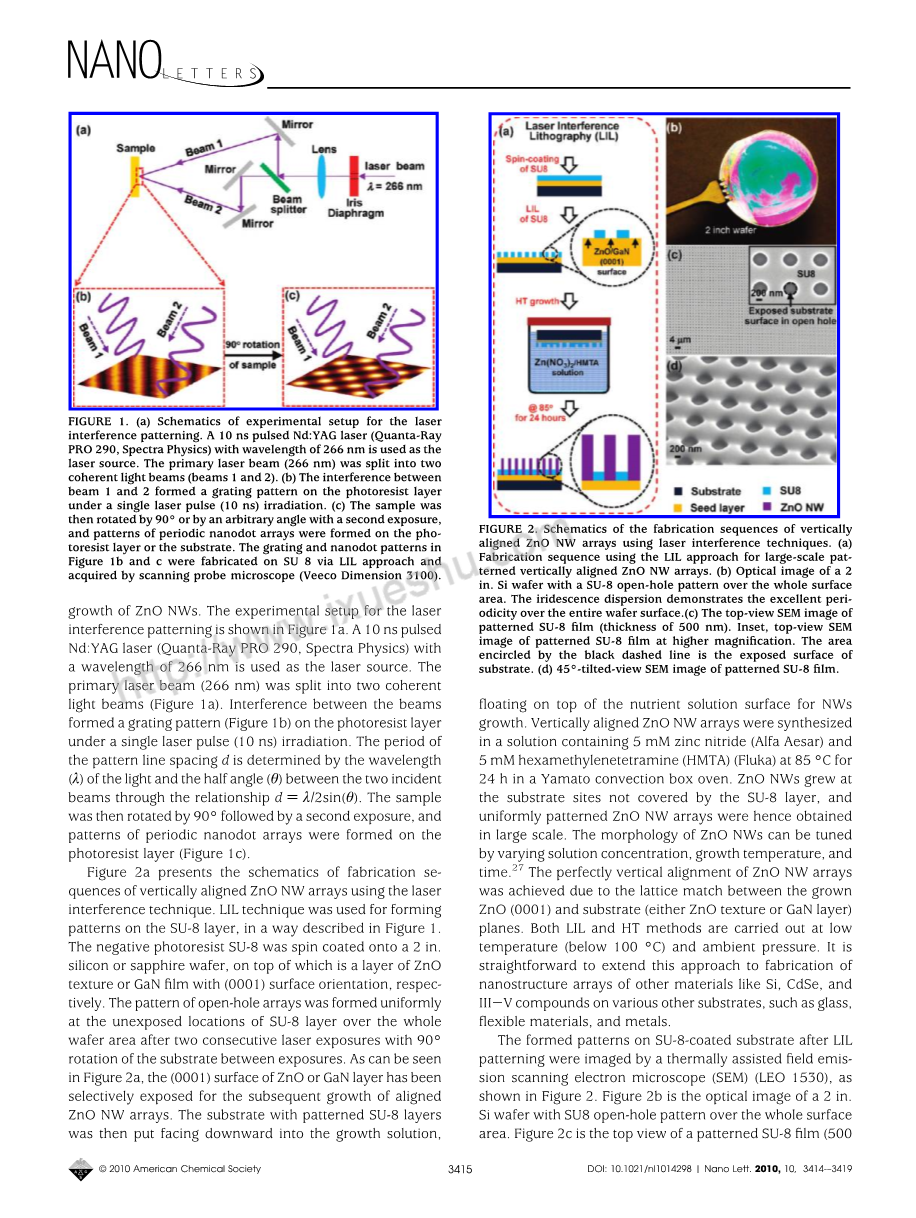
英语原文共 7 页,剩余内容已隐藏,支付完成后下载完整资料
晶圆级高通量有序垂直排列的ZnO纳米线阵列的生长
摘 要
本文提出了一种有效的方法,可以在不使用洁净室技术的情况下,以晶圆级的高产量和低成本进行垂直排列的ZnO纳米线(纳米线)阵列的图案化生长。使用激光干涉光刻在涂有光刻胶SU-8的基板上生成周期性的孔图案。ZnO纳米线通过低温水热方法选择性地通过孔生长,而无需使用催化剂,并且具有对取向,位置/密度和合成形态的出色控制。用于替代单晶GaN底上大规模垂直排列的ZnO纳米线阵列的制造。这种组合方法展示了一种在各种基板上制造大规模图案化一维纳米结构的新颖方法,可用于能量收集,传感,光电和电子设备。
关键词:氧化锌 纳米线 阵列 激光干涉光刻 纳米加工
ZnO纳米线(NW)是用于能量收集,1-5传感,6,7光电,8,9和电子应用。大规模组装和集成高阶纳米线阵列对于多功能设备和系统至关重要。12-14在通过并行过程组装大量纳米线方面已经做出了巨大的努力,这些过程可以分为两类:即按即用(GAP)和按需按地生长(GIP)。GAP方法包括但不限于介电电泳15和利用磁场16 以及微流体,17静电,18分子,19和剪切力诱导的比对。20-22尽管可以使用GAP技术来制造有限数量的设备,但将合成后的纳米线大规模组装成所需的配置是相当困难的。在GIP技术中,纳米结构在通过光刻技术(例如电子束光刻(EBL),23纳米压印光刻技术(NIL),24和纳米球光刻技术(NSL))形成的图案化催化剂/种子位置上原位生长。25对生长基质的控制可以指导生长的纳米线的尺寸,位置和方向。通过水热(HT)方法23和物理气相沉积(PVD)已经实现了取向ZnO纳米线的图案生长。25但是,以上方法均不能为工业化应用所需水平的图案化ZnO纳米线阵列的大规模制造提供可靠,高吞吐量和低成本的解决方案。
为了实现大规模,高产量,低成本,高度有序排列的ZnO 纳米线的可控生长,有必要采用构图技术和ZnO 纳米线合成方法的可行组合。在这封信中,我们通过结合激光干涉光刻(LIL)26(这是一种大规模,快速,无掩模和非接触式纳米图案化技术以及ZnO的HT生长)展示了一种用于垂直排列的ZnO纳米线阵列的图案化生长的方法。纳米线27要么同质外延地在纹理化的ZnO层上(也可以通过化学湿法合成),要么异质外延地在GaN膜上。可以通过LIL在高达2英寸晶圆的大面积上以周期性有序,可变间距和对称性对基板进行构图。然后,通过低温HT方法在不使用催化剂但可以控制方向,尺寸和位置的情况下,在预定位置生长完全对齐的垂直ZnO 纳米线阵列。合成后的纳米线的长度和直径高度均匀,排列完美,是沿[0001]方向生长的单晶。
图1(a)激光干涉图样的实验装置示意图。使用波长为226nm的10ns脉冲Nd;YAG激光器( Quanta- - Ray PRO 290 , Spectra Physics )作为激光源。初级激光束( 266 nm )被分成两个相干光束(光束1 和2)。(b)在单个激光脉冲(10ns)照射下,光束1和光束2之间的干涉在光致抗蚀剂层上形成了光栅图案。(c)然后通过第二次曝光将样品旋转90°或旋转任意角度,并且在光致抗蚀剂层或基板上形成周期性纳米点阵列的图案。图1b和c中的光栅和纳米点图案是通过LIL方法在SU 8上制造的,并通过扫描探针显微镜(Veeco Dimension 3100)获得。
通过光致抗蚀剂的LIL制备用于合成ZnO 纳米线阵列的图案,这是与现有光刻工艺类似的光化学工艺。在我们的实验中采用了微电子工业中常用的基于环氧的负性光刻胶SU-8。LIL技术可在光致抗蚀剂上无掩模地产生图案。当暴露时,SU的长分子链交联并引起暴露区域的固化。显影后,保留了SU-8层的裸露区域,并作为SU-8层的掩膜。
图2 使用激光干涉技术的垂直排列ZnO纳米线阵列的制造顺序示意图。(a)使用LIL方法进行大规模图案化垂直排列的ZnO纳米线阵列的制造顺序。(b)英寸的光学图像在整个表面积上具有SU-8裸眼图案的硅晶片。虹彩分散体在整个晶圆表面上表现出出色的周期性。(c)图案化的SU-8膜(厚度为500nm)的俯视SEM图像。图案化的SU-8胶片在较高放大倍数下的嵌入式俯视SEM图像。黑色虚线包围的区域是基板的暴露表面。(d)图案化的SU-8膜的45°倾斜SEM图像。
ZnO纳米线的生长。激光干涉图案化的实验装置如图1a所示。使用波长为266 nm的10 ns脉冲Nd:YAG激光器(Quanta-Ray PRO 290,Spectra Physics)作为激光源。初级激光束(266 nm)分为两个相干光束(图1a)。在单个激光脉冲(10 ns)照射下,光束之间的干涉在光致抗蚀剂层上形成了光栅图案(图1b)。图案线间隔d的周期由光的波长( lambda; )和两个入射光束之间的半角( theta; )通过关系d lambda; / 2sin( theta; )确定。然后将样品旋转90 ° ,然后进行第二次曝光,然后在光致抗蚀剂层上形成周期性纳米点阵列的图案(图1c)。
图2a给出了使用激光干涉技术的垂直排列的ZnO纳米线阵列的制造顺序示意图。LIL技术用于以图1中所述的方式在SU-8层上形成图案。将负光致抗蚀剂SU-8旋涂到2英寸的硅或蓝宝石晶片上,其顶部分别是一层具有(0001)表面取向的ZnO纹理或GaN膜。在两次连续的激光曝光后,在两次曝光之间使基板旋转90 ° 之后,在整个晶片区域的SU-8层的未曝光位置均匀地形成裸眼阵列的图案。如图2a所示,ZnO或GaN层的(0001)表面已被选择性暴露,以用于后续生长的ZnO 纳米线阵列。然后将具有图案化SU-8层的基材面朝下放入生长溶液中,漂浮在营养溶液表面的顶部,以促进纳米线s的生长。垂直排列的ZnO 纳米线阵列是在Yamato对流箱式烤箱中于85 ° C的溶液中合成的,该溶液包含5 mM氮化锌(Alfa Asar)和5 mM六亚甲基四胺(HMTA)(Fluka),温度为85 h。ZnO 纳米线s在未被SU-8层覆盖的衬底位置生长,因此获得了大面积均匀图案化的ZnO 纳米线阵列。可以通过改变溶液浓度,生长温度和时间来调整ZnO 纳米线的形态。27由于生长的ZnO(0001)与衬底(ZnO织构或GaN层)平面之间的晶格匹配,实现了ZnO 纳米线阵列的完美垂直对齐。LIL和HT方法都在低温(低于100°C)和环境压力下进行。将这种方法直接扩展到在各种其他基板(例如玻璃,柔性材料和金属)上制造其他材料(如Si,CdSe和III-V化合物)的纳米结构阵列。
如图2所示,通过热辅助场发射扫描电子显微镜(SEM)(LEO 1530)对LIL图案化后在SU-8涂层基板上形成的图案成像。图2b是2英寸的光学图像。在整个表面积上具有SU8裸孔图案的硅晶片。图2c是SU-8图案胶片(500 nm厚)。呈现的图案具有2 mu; m的周期,并且直径为600nm的圆形孔在表面上均匀地开有3.5mJ / cm 2 的照射通量。孔的侧壁近似垂直,并且衬底被选择性地暴露(分别在图2c和d中的顶视图和45 ° 倾斜视图)。可以通过改变激光干涉图样化参数(例如注量和孔径大小)以及其他实验参数(如两次曝光之间施加到样品的旋转角度)来调整图案的形状,周期和孔的比例。有关模式生成的详细研究将在本文后面讨论。
图3 3 。通过 LIL 方法在 GaN 衬底上垂直排列的 ZnO 纳米线阵列的异质外延生长。(a和b)在 GaN 衬底上垂直对齐的 ZnO 纳米线 阵列在不同放大倍数下以大规模模均匀图案的俯视 SEM 图像。(c 和d ) GaN 衬底上垂直对齐的 ZnO 纳米线 阵列在不同放大倍率下以大规模均匀图案的 45° 倾斜 SEM 图像
首先研究了GaN衬底上垂直排列的ZnO 纳米线阵列的异质外延生长。通过LIL方法对图案化的纳米线阵列的形态和均匀性进行了检查,并通过SEM图像进行了确认(图3)。几乎所有纳米线都具有相同的直径和高度。对准后的ZnO 纳米线阵列在高保真度的图案化孔之后均匀生长直径约为600 nm(图3b)。所有的纳米线都垂直于基板完美对齐并具有约5 micro; m的相同高度(图3c和d)。
ZnO 纳米线阵列的LIL图案化生长还使用了不同时间和大小的GaN衬底上的开孔(支持信息,图S1)。当比较ZnO纳米线阵列中具有不同直径的孔的图案时,观察到一个有趣的现象。当开孔的直径小于600 nm时(支持信息,图S2a-d和图3),单个ZnO 纳米线从每个孔中生长出来。所有纳米线具有相同直径和高度的完美垂直对齐。当开孔的直径大于1 micro; m时,会观察到ZnO 纳米线的随机生长(支持信息,图S2e-h)表示生长的ZnO 纳米线的直径和高度不同,这与在未图案化的裸GaN衬底上生长的ZnO纳米线的结果相似。从成核和生长过程可以理解该选择性区域的生长。核在生长开始时形成,当核的大小超过临界大小时,核将启动并引导纳米线的后续生长。纳米线生长与细胞核形成之间存在竞争。开放空间中的竞争由于其较大的尺寸和多个核,导致纳米线阵列的随机增长。当用于纳米线生长的表面被限制在彼此隔开一定距离的小区域中时,在每个被限制的光斑中都会形成一个核,然后它会长成一个纳米线。Coltrin等人28提出的二维模型还通过在模型中引入反应副产物的扩散机制来描述选择性区域的生长。可以使用上述LIL方法针对不同的图案尺寸进一步研究选择性区域生长的机理。对选择性区域生长的更深入的了解可以使以更可控的方式制造大规模的图案化ZnO纳米线阵列。
图4.通过LIL方法在带纹理的ZnO种子层上大规模垂直排列的ZnO 纳米线阵列的同质外延生长。(a)XRD测量研究生长的织构ZnO晶种层的晶体结构和取向。(a1)theta;-2theta;扫描仅在34.45°和72.59°处显示两个主峰,分别归因于ZnO(0002)和(0004)平面。(a2)还研究了织构的ZnO种子层的theta;摇摆曲线,该峰在34.45°处出现,半峰全宽(fwhm)值为1.47°。 fwhm值小表明织构的ZnO种子层的不同(0001)取向畴之间具有良好的对齐方式。(a3)插图分别是准备好的织构ZnO种子层的俯视图和45°倾斜视图。通过沿[0001]方向生长的紧密致密的ZnO 纳米线形成ZnO种子层。那些纳米线具有平坦的顶部(0001)表面,并且高度阶跃变化很小(图4a3插图)。(b)生长的致密的ZnO层的横截面。发现在支撑衬底上的一层预溅射的ZnO种子层(约200 nm厚,如图4b所示)对于生长致密的ZnO层是必需的。 确认生长后的致密质感ZnO层顶表面的高度变化很小。 (c和d)硅基板上垂直排列的ZnO 纳米纳米线阵列的插图以及俯视和45°倾斜SEM图像,其上具有纹理化的ZnO层,且在不同放大倍率下具有大规模均匀的图案。
为了通过HT或物理气相沉积方法实现垂直排列的ZnO纳米线阵列,需要基板材料和ZnO之间的晶体取向和晶格参数匹配。先前采用诸如单晶GaN25或ZnO29之类的衬底进行纳米线生长。然而,这些基板的高成本限制了潜在的大规模应用。此外,由于成本和处理方面的考虑,使用诸如聚合物和玻璃之类的其他材料的基板的应用已引起人们的更多关注。因此,非常需要开发一种基本上在任何低成本衬底上制造垂直取向的ZnO 纳米线阵列的通用方法。在覆盖有通过射频磁控溅射制备的多晶ZnO籽晶层的硅晶片上执行相同的LIL图案化和HT纳米线生长顺序。由于沉积在硅晶片上的多晶ZnO晶种的随机面内取向,多个ZnO纳米线(支持信息,图S2)从每个孔中生长出来。因此,理想的是具有平坦(0001)表面的带纹理的ZnO种子层,用于后续垂直排列的ZnO 纳米线阵列的生长,并且我们开发了一种简单的方法来以低成本制备具有平坦(0001)表面的大规模带纹理的ZnO种子层。
首先,在射频磁控溅射系统中,用厚度约为200 nm的ZnO层溅射硅晶片(图4b)。然后将薄饼面向下放入生长溶液中,漂浮在营养液表面的顶部以进行生长。在Yamato对流箱式烤箱中,在95 ° C下,在含有20 mM氯化锌(ZnCl 2 )和20 mM HMTA的溶液中,合成了一层致密的ZnO 纳米线致密层,历时16 h。还以约4%的体积浓度将氢氧化铵(NH 4 OH)添加到溶液中。对齐的ZnO 纳米线致密层的横截面如图4b所示。图4a3及其插图分别是准备好的织构ZnO种子层的俯视图和45°倾斜图。ZnO种子层由沿[0001]方向生长的紧密致密的ZnO 纳米线形成。那些纳米线具有平坦的顶部(0001)表面(图4a3),并且高度台阶的变化很小(图4a3插图和b)。通过X射线衍射(XRD)测量研究了生长的织构ZnO种子层的晶体结构和取向。XRD theta; -2 theta; 扫描(图4a1)仅在34.45 °和72.59 ° 处显示两个主峰,分别归因于ZnO(0002)和ZnO(0004)平面。XRD theta; -2 theta; 扫描表明织构的ZnO种子层的表面取向为(0001)。还研究了织构的ZnO种子层的XRD theta; 摇摆曲线(图4a2)在34.45 ° 处有一个峰,半峰全宽(FWHM)值为1.47 ° 。FWHM值小表明织构的ZnO种子层的不同(0001)取向畴之间具有良好的对准性。
图5.(a1-a3)具有纹理化ZnO种子层的Si衬底上不同开孔尺寸的SU-8图案的SU-8图案的俯视SEM图,干涉光通量分别为1.6、3.2和6.0 mJ / cm 2。 (b1-b3)使用与a1-a3中相同的激光通量,模拟SU-8中的激光通量分布。 (c1-c3)垂直对齐的ZnO 纳米线
剩余内容已隐藏,支付完成后下载完整资料
资料编号:[411100],资料为PDF文档或Word文档,PDF文档可免费转换为Word


