
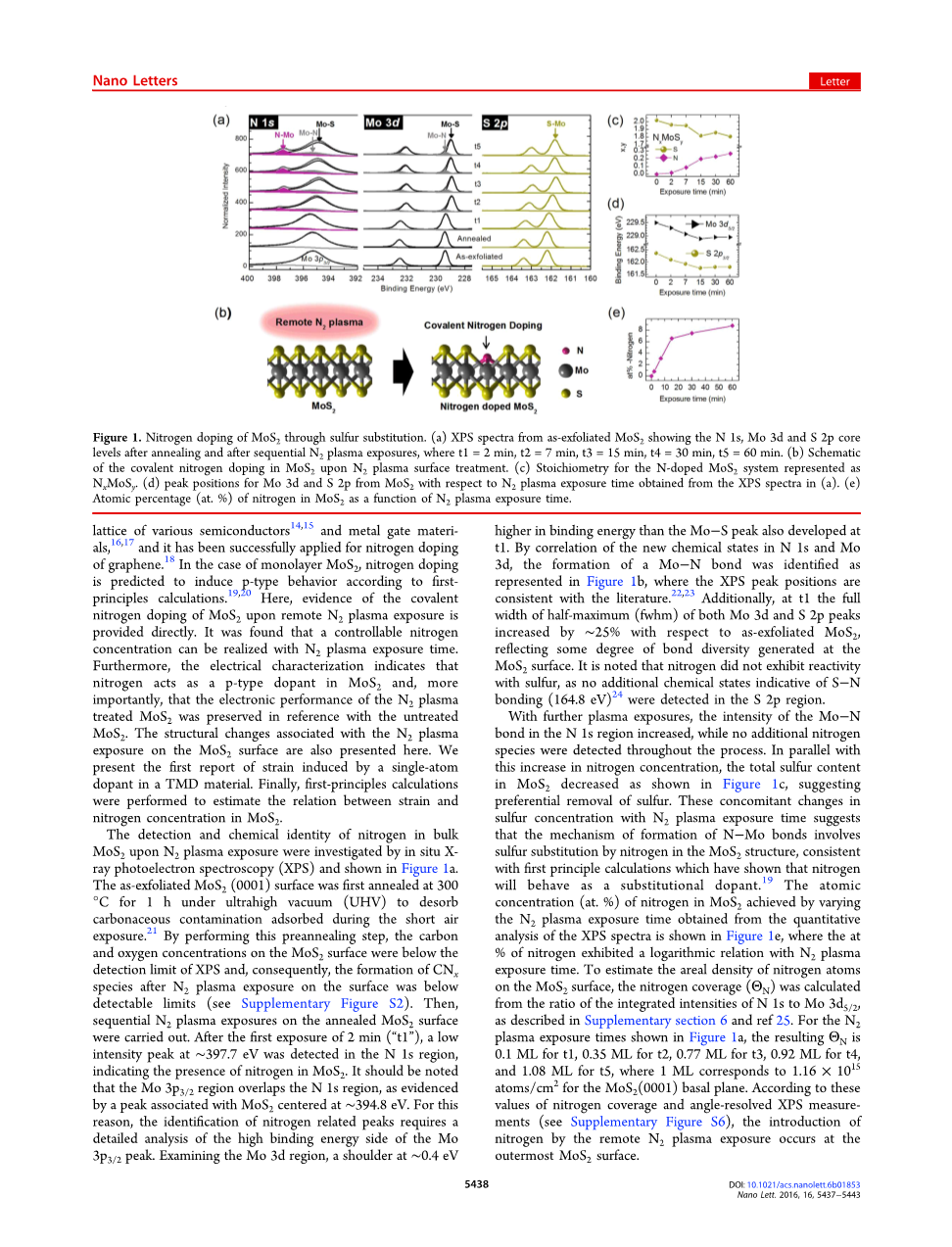
英语原文共 7 页,剩余内容已隐藏,支付完成后下载完整资料
共价氮掺杂和通过远程接触N2等离子体MoS2的压缩应变
Angelica Azcatl,dagger;Xiaoye Qin,dagger;Abhijith Prakash,Dagger;Chenxi Zhang, dagger;Lanxia Cheng,dagger;Qingxiao Wang,dagger; Ning Lu,dagger; Moon J. Kim,dagger; Jiyoung Kim,dagger; Kyeongjae Cho,dagger; Rafik Addou,dagger; Christopher L. Hinkle,dagger; Joerg Appenzeller,Dagger; and Robert M. Wallace*,dagger;
dagger;Department of Materials Science and Engineering, The University of Texas at Dallas, 800 West Campbell Road, Richardson, Texas 75080, United States
Dagger;Department of Electrical and Computer Engineering, Birck Nanotechnology Center, Purdue University, West Lafayette 47907, Indiana United States
摘要:在二维材料异质和同质p-n结的可控掺杂是理想器件非常理想的性能。在此,我们提出了通过远程N2等离子体表面处理的有效策略进行氮掺杂的MoS2。MoS2表面暴露在N2等离子体中,利用X射线光电子能谱进行原位化学监测,确定存在共价键合氮MoS2。氮替代硫属元素为该掺杂的为掺杂机理。此外,电学特性表明,氮掺杂来实现了二硫化钼的p型掺杂,这与理论预测是一致的。
值得注意的是,我们发现,氮的存在会导致MoS2结构压缩应变,这是第一个证据,通过掺杂在过渡金属硫化物材料应变。最后,我们的第一原理计算支持这种应变试验示范,并与氮的掺杂浓度和压应变在MoS2的相关阐述。
关键词:共价,p型掺杂,MoS2,应变, N2等离子体。
二维过渡金属二硫醚(TMDs)已经开启了在场效应晶体管中减小半导体通道材料厚度的可能性。(FETs)减小到亚纳米级,避免由于量子限制效应而导致的三维晶体中带隙的急剧增加[1]。然而,对于实现基于TMD的器件(如p-n二极管、FETs、隧道FETs),TMD材料的掺杂类型和掺杂浓度是关键参数。在这方面,使用NO2[2]、聚乙烯亚胺[3]、苄基紫精[4] 等分子的掺杂研究,发现通过电荷转移是掺杂TMDs的重要一步。然而,由于掺杂剂分子的非共价键结合性质,这一方法受到时间的波动限制,对掺杂浓度的控制成为一项挑战。静电掺杂是另一种方法,使用聚合物电解质或离子液体浸透或涂覆TMD通过 [5minus;7],依靠外加电压调制掺杂密度。除了这些技术外,在TMD晶格中通过金属或氧属元素替代TMDs的单原子进行共价掺杂,是实现稳定、可控掺杂的潜在途径。通过Nb在生长过程中替代Mo,形成共价p型掺杂的MoS2[8,9]。此外,替代掺杂可以为TMD材料带来新的功能,如光带隙调谐[10]或磁行为[11]的前景。
采用等离子体处理技术在MoS2中加入氟[12]和磷[13]。然而,这些等离子体辅助的掺杂过程会产生不良的副作用,如对各自的等离子体掺杂的MoS2 FETs的离子电流的层腐蚀和降解,这表明对TMDs的等离子体处理的改进还有待开发。通过对TMDs等离子体辅助掺杂策略的探索,研究了利用远程 N2等离子体处理在MoS2中引入氮作为掺杂原子的研究。 N2等离子体暴露是一种实用的技术,已广泛应用于将氮原子加入各种半导体晶体中[14,15]和金属栅极材料[16,17],现已经成功地应用于石墨烯的氮掺杂。[18]在单层MoS2的情况下,根据共价计算原则,预计氮掺杂会形成p型 [19,20。将MoS2远端暴露在N2等离子体中,直接实现MoS2的氮掺杂。研究发现,氮气浓度可以通过 N2等离子体暴露时间来实现。此外,电学特性表明氮在MoS2中扮演p型掺杂剂的作用,更重要的是, N2等离子体处理过的MoS2仍保留了掺杂前MoS2的电子性能。本文还介绍了MoS2表面与 N2等离子体接触后其有关的结构变化。本文首次报道了一种单原子掺杂剂在TMD材料中所引起的应变。最后,利用第一原理计算了MoS2中应变和氮浓度之间的关系。
图1
采用硫取代法对MoS2进行氮掺杂。从即剥离二硫化钼(a)XPS谱显示N 1 S,莫3 d和2 p退火后核心水平和顺序氮气等离子体接触后,在t1 = 2分钟,t2 = 7分钟,t3 = 15分钟,t4 = 30分钟,t5 = 60分钟。(b)示意图共价氮掺杂的二硫化钼在N2等离子表面处理。(c)以NxMoSy为代表的n - dopedmos2系统的化学计量。(d) MoS2中Mo 3d和S 2p的峰值位置,从XPS光谱(a)中获得的N2等离子体暴露时间。(e)原子百分比(at%)MoS2中的氮作为N2等离子体暴露时间的函数。
采用原位x射线光电子能谱(XPS)对暴露在等离子体N2中MoS2中氮的检测和化学特性进行了研究,如图1a所示。即剥离的二硫化钼(0001)表面1 h超高真空(特高压) 300°C下退火,解除在短的空气污染暴露而吸附碳质[21]。通过这一退火步骤,MoS2表面的碳和氧浓度低于XPS的检测极限,因此,在表面上N2等离子体暴露后,CNx物种的形成低于可检测的限度(见补充图S2)。然后,对退火的MoS2表面进行了连续N2等离子体照射。在第一次暴露2 min(“t1”)后,在N 1s区检测到低强度峰值,在397.7 eV,表明在MoS2中存在氮。应该指出的,Mo 3p3/2区域与N 1s区域重叠,这是由与MoS2中心在3394.8 eV相关的峰值所证明的。因此,对氮相关峰的识别需要对Mo 3p3/2峰高结合能侧进行详细的分析。检查Mo 3d区域,在0.4 eV显示一个肩部。在t1时间还产生了比Mo-S更高的结合能峰。在N 1S和Mo 3d键新化学态的相关性,图1 b证实了Mo minus;N键的形成,其XPS的峰值位置与文献一致 [22,23] 。另外,在t1下,Mo 3d和S 2p峰的半高宽(FWHM)的最大宽度增加了25%,这反映了在MoS2表面生成某种程度的键的多样性。有人指出在S 2p地区域发现氮没有表现出与硫反应, 没有额外的化学状态表明Sminus;N键(164.8 eV)[24]。
进一步与等离子体接触Mminus;N键的强度增加, 在整个过程中在N 1s区域虽然没有发现额外的氮物质。随着氮浓度的增加,MoS2的总硫含量降低,如图1c所示,表明硫已不占主导地位。伴随硫浓度的变化与氮气等离子体曝光时间,表明形成Nminus;M键的机制,包括硫氮取代的二硫化钼结构,与第一原理计算符合。氮为替换掺杂剂[19]。通过对XPS光谱定量分析获得N2等离子体暴露时间和原子浓度(at. %)的变,得到了MoS2中氮的原子数百分比,如图1e所示,其中氮原子数百分比与N2等离子体暴露时间呈对数关系。估计二硫化钼表面氮原子的磁录密度、氮覆盖率(Theta;N)从综合强度的比值计算N 1s, Mo3 d5/2, 见第六节补充所述和文献25。氮气等离子体曝光时间如图1所示, 根据这些氮覆盖和角分辨XPS测量值(见补充图S6),在最外层的MoS2表面暴露在远端N2等离子体中,在二硫化钼(0001)表面生成的Theta;N:t1 0.1毫升, t2 0.35毫升, t3 0.77毫升, t4 0.92毫升, t5 1.08毫升, 1毫升对应 1.16 times; 1015 原子/cm2。
以前曾有报道称,渗氮的二硫化钼是通过暴露二硫化钼粉剂NH3在750°C。另一种用溶胶凝胶法合成MoS2纳米片,通过对MoS2的氮掺杂方法进行的[26]。相比之下,利用氮气等离子体过程中描述这个工作是一个可氮掺杂剂浓度控的过程。新成立的Mominus;N共价键是由于强烈的杂交N 2p和Mo 4d轨道杂交的结果。[27、28]。事实上,在500°C退火MoS2保持了良好热稳定性和较低的解吸 (见附加图S4)。
根据Mo 3d和S 2p的峰值位置,刚剥离的 MoS2表面表现出常见n型掺杂[29]。有趣的是,XPS光谱中,在t1到t3区域,N2等离子体照射下与N2等离子体接触的低结合能峰是一致的,如图1c所示,显示了与p型掺杂有关的费米能级的变化[29]。然而,对氮掺杂MoS2 (n掺杂MoS2)的费米能级转移大小的解释并不简单。由于氮的存在,作为一个p型掺杂剂[20] 电荷转移引起能带弯曲,在顶层Mominus;N共价键的形成,硫原子减少[30],都对测量产生了影响。对价带的整体影响表明,费米能级更靠近MoS2价带。
图2。
氮在MoS2中的p型掺杂效应。(a)的能带图即剥离二硫化钼和氮掺杂二硫化钼、功函数的地方(Phi;)和价带最大(VBM)从XPS测量获得的二次电子截止能量和价带边缘,分别。在这两种情况下,带隙(Eg)被假定为体积MoS2(1.23 eV)[31]。测量Phi;和VBM值被用来估计电子亲和能(chi;)。这里显示的所有值都在eV单元中。(b)idminus;vg多层氮掺杂二硫化钼场效应晶体管的特性。(c)在本研究中使用的 SiO2/Si结构的后控氮掺杂MoS2FET的示意图。(d) Vth对MoS2层厚度的依赖,绘制的线引导眼睛。
在N2等离子体处理15 min之前和之后的MoS2的能带排列如图2a所示。假定对氮掺杂保持不变带图由XPS测量(见补充图S5) 和采用块体二硫化钼带隙值1.23 eVplusmn;0.02 eV [31]。图2显示,氮气等离子体处理后功函数(Phi;)增加,对刚剥离MoS2,价带最大(VBM)位于费米能级以下0.87 eV,氮掺杂后的MoS2到偏移到0.34 eV的,费米能级的变化提供了p型掺杂的证据。还注意到,在本研究中描述的掺杂过程中,MoS2表面的氧和碳浓度低于XPS检测极限(见补充图S3)。因此,在MoS2中,氮是唯一参与费米能级转移到价带的元素。最后,在氮掺杂后,估计的电子亲和度降低,这可能与从硫到氮的MoS2表面终止的改性有关。[32]
为了进一步研究掺氮MoS2的电学性能,并支持XPS给出的p型掺杂的初步证据,用该装置结构制作了背控场效应晶体管(FETs),如图2c所示。对于电特性,在SiO2/Si衬底上不同厚度的MoS2薄片上进行了15 min N2等离子体接触。图2 b显示了Idsminus;Vgs特征代表背栅N掺杂的多层二硫化钼场效应晶体管。注意,在所有测量中,相同的扫描条件和栅极电压范围被用来允许对不同设备进行适当的比较。此外,虽然我们的设备确实存在磁滞现象,但我们确保所有的阈值电压都是通过从状态(正栅电压)到输出电压(负栅电压)的状态(负栅电压)来提取的。这种方法产生的设备特性几乎与其他仅通过脉冲测量[33]得到的结果相同,而这种脉冲测量是已知的,可以产生几乎滞后的自由特性。阈值电压Vth的正向位移与MoS2[34]中期望的p型掺杂行为一致,但未观测到特征的p型分支,这可能是由于金属接触到MoS2 传导带附近的金属接触而引起的[35]。有趣的是,与Nb[36]或NO2[2]的掺杂相比,在N2气等离子体暴露后,没出现掺杂退化的现象,这凸显了该过程的优势,即在应用电压的控制下保持了设
剩余内容已隐藏,支付完成后下载完整资料
资料编号:[462456],资料为PDF文档或Word文档,PDF文档可免费转换为Word


