光刻技术的结局及其后续者的展望
摘要:这个报告从叙述光刻技术的历史开始,从它大于2微米到亚100nm的时代。为了增加分辨率和保持深度的聚焦,波长从436减少到365,248和193nm,数值孔径从0.15增加到0.93,通用分辨率指标k1,从0.8下降到0.3。似乎没有扩展光刻技术的空间。幸运的是193nm光线的浸水铺平了道路,达到1.35NA。显示了最近来自0.85NA,193nm浸没式扫描仪的全芯片结果以及其余的浸没式光刻问题。从这一刻起,光刻技术正在开始其结局。讨论了延长其末端的技术,如高折射率浸入液和透镜材料,偏振照明,掩膜固体浸没,双重曝光和间距分离。光刻技术的潜在后继者包括EUV光刻,高压和低压电子束直写系统。给出了它们的优缺点和财务影响。
关键词:微光刻术;光学光刻;浸没式光刻;EUV光刻;电子束光刻;直写光刻
1.前言
自成立以来,光刻技术一直是半导体制造业的主力军。光刻技术的消亡经常被预测,但未能实现[1]。例如,1微米的分辨率被认为是一个可怕的障碍。因此,电子束直接写入系统被开发出来[2],准备接管光学光刻技术。使用波长减少超过2个数量级的X射线接近式印刷已经试图从1微米开始成功地进行光刻,但是在0.25微米尝试处失败。笔者预测光学光刻技术将会达到0.13微米,波长减小到193nm,透镜数值孔径(NA)增加到0.65,分辨率增强技术将通用分辨率指标k1降低到0.35。然而,光学光刻技术在化学机械抛光的辅助下进行,使地形变得平缓来减少聚焦深度(DOF)要求,并进一步增加NA。投影光学光刻技术的发展如图1所示。它起始于0.15NA436nmg-线透镜特性分辨率超过2微米,使用k1系数为0.8,通过提高NA直到透镜变得太昂贵时,减少波长以重新定位下一轮增加的NA,并且每当NA和波长改变的速度落后于电路缩小路线图时,降低k1。这一趋势持续到365,248和193nm,并持续到157和13.4nm。值得注意的是半间距分辨率早在0.55NA和0.5k1的365nm波长就迅速变为亚波长。大于波长成像的机会将仅在13.4nm波长处重新出现。
光刻技术遇到了193nm以上的巨大问题。用于157nm光刻的唯一透镜材料CaF2具有以足够的数量和可降价的价格获得157nm成像所需质量的问题。光刻胶的吸收量太大,更不用说满足其他要求,如耐蚀性,灵敏度,线边缘粗糙度,曝光后烘烤敏感度和成本。157nm刻的致命弱点是缺乏柔软掩膜。在仅用少量157nm脉冲照射后,薄膜型的掩膜就从不透明状态转移。较厚的硬膜片必须作为成像系统中的光学元件进行处理,要求更高的光学质量和安装的一致性,导致前者的成本较高,后者的技术难度较大。
将波长减少一个数量级以上至13.4nm,开辟了缩减NA和k1的新潜力,以便长期处理更多的节点。该技术的目标是在100nm的半间距上进行光学光刻,但许多问题延迟了它的推出。
最近,浸没式光刻的引入进一步将193nm系统的有效波长减小到134nm。使用k1=0.3和NA=1.35,并在193nm波长处进行水浸时,已经预测了具有45nm半间距的半导体的制造[3]。
本文介绍了193纳米浸没式光刻技术的进展及其遇到的问题,随后介绍了将193纳米浸入式光刻技术扩展至其最终潜力的方法。32纳米-半间距可能是其他类型光刻的良好切入点。我们将在技术挑战和成本方面对这些技术进行比较。
2.193nm浸没式光刻
2.1.193纳米水浸光刻的现状
193nm水浸已经应用于逻辑器件和电路,以探索其潜力并摆脱其问题。图2显示了叠加在有源层上的90nm节点SRAM的多晶硅图像[4]。前者在0.75NA193nm浸没式扫描仪上曝光,后者在相同的干燥系统上曝光。它展示了全场成像,可用的抗蚀剂系统,可接受的覆盖层和大的自由度。转向0.85NA193nm浸没式扫描仪,55nm节点的SRAM芯片被破坏。图3显示了该芯片在不同场地的金属层图像。图4比较了在接触层干式浸渍分裂中良好的模具数量与坏的数量[5]。尽管有浸没诱发的缺陷,但比例为72:70比62:80。如果非拍照的错误操作被打折,浸没好的模具的数量将会增加25个,达到97:45。
然而,浸没式光刻技术并不完全符合人体工程学。其晶片的吞吐量仍略低于干柜。虽然可以接受,但叠加性能也比干燥工具稍差。或许,最迫切的挑战是将干燥光刻的缺陷级别降低到一位数。使用最先进的检测工具,仔细控制曝光,发现缺陷的数量是两位数。
图5显示了浸没式曝光的三种主要缺陷类型,即水渍,气泡和颗粒。水渍是由于浸渍头通过后抗蚀剂表面的残余润湿。可以通过防止残留润湿,通过材料处理和/或通过特殊处理来控制。曝光期间水中的气泡会改变抗蚀剂图像,就好像放大镜在曝光过程中被插入一样。气泡主要是由于在步进和扫描过程中流体动力学的破坏而引起的。颗粒可以在供水中或从水接触并传送到晶片的任何表面携带。其中一种主要怀疑来自晶片边缘附近。图6显示了一种有效的曝光后浸泡方法,以去除在给定范围的条件下产生的水渍。新的浸没式设计显着减少了气泡的数量。图7是在普通晶片上的进行的多重曝光研究,旨在区分静态和动态缺陷。在晶片上发现的85个缺陷中,在5次小型曝光后存活的仅有约1/4。每次曝光期间在不同地点的其他缺陷都被拒之门外。这个实验是用一层覆盖在光敏材料上的外套和曝光后的烘培去简化所产生的缺陷的类型。我们可以将大多数动态定位的缺陷归因于气泡,而将静态的缺陷归因于粒子。
2.2将193nm浸没式光刻技术扩展到极限
在193nm的浸没式光刻技术中,可以使用更多的技术来扩展超过45nm半间距,即使用高折射率材料,偏振照明,固体掩模浸入和双重曝光。
2.2.1高折射率材料
折射率接近1的空气一直限制着从镜头到抗蚀剂的空间频率耦合。在193nm处折射率为1.44的水要好得多。理论耦合极限将水浸193nm系统的最大NA设置为1.44。然而,对于成像镜头使用sinh=0.95的实际上限,实际NA限制为1.368。要突破这个限制,必须使用更高折射率的耦合流体。图8描述了可能性。保持sinh=0.95,n=1.56的流体将限制移动到NA=1.482。由于熔融石英的折射率约为1.56,而CaF2的折射率较低,因此折射率高于1.56的浸润液不能在镜片底部支撑较高的NA。例如,在n=1.66时,最大实际NA仍然是1.482,除了由于流体中较小的角度,DOF较大。在透镜材料中保持nlt;1.56,将NA提高到1.482以上的唯一方法是弯曲最后一个透镜表面,如图9所示。有一个非平面的底透镜表面需要在耦合介质中极低的吸收。否则,光线会被不均匀地吸收,导致成像困难。流体动力学也是支持者。为了保持底部透镜表面平坦,需要较高折射率的光学材料。尽管目前还没有做好实际应用的准备,但是最近的第二届国际浸没式研讨会[6-8]已经提出了折射率从1.5到1.8的193纳米浸润流体和折射率从1.6到2.0的透镜材料。
2.2.2偏振照明
随着电场矢量的任意方向朝向晶片传播的光波可以被分成两个分量;横向电场(TE),电场矢量平行于抗蚀剂表面,横向磁场(TM)与磁场矢量平行。就空间频率的组合而言,TE模式是最有效的。所有TE空间频率都有其电场向量彼此共线。它们完全叠加,不会留下未组合的杂散光。在TM模式下,电场矢量的组合效率是入射角的函数,较小角度的效率较低。不结合方向相反方向的组合,变成杂散光以减少图像对比度。当照明仅限于TE模式时,即使在大入射角度下图像对比度也会保留。
图10表示具有成像光的空间频率,反射光,系统杂散光(SSL)和偏振相关杂散光(PDS)的形成的投影-印制系统的示意图。光栅掩模将光线分成0度,plusmn;1度,plusmn;2度。它们被表面粗糙度所分散,并且在透镜表面上由不完美的抗反射涂层多次反射。它们也被掩模吸收器反射。所有这些都变成了偏振相关的SSL,但由于许多不同反射面,入射角和反射角的平均效应,其效果并不强。由于不完全阻挡,被镜头光圈阻挡的plusmn;2阶光束也可能变成杂散光。现在,在抗蚀剂/晶片和抗蚀剂/耦合介质界面传输和反射的0和plusmn;1阶光束强烈偏振相关。TM发射光束进入抗蚀剂中不会完全重组。反射的TE和TM光束像透镜一样被透镜表面散射和多次反射,并被掩模吸收器反射。他们诱发另一级别的杂散光。造成的对比度损失导致曝光宽容度和DOF降低。
给定8%的曝光宽容度,65nm相等的线条和空间的DOF在图11中绘制为193纳米水浸,193纳米干燥和132纳米干燥系统[9]。使用波长132nm是因为水的折射率的在较早的报道值[10,11]为1.46.由于调整波长1.4%不会在图中产生任何可感知的差异,因此132nm不会更新。具有最大DOF的曲线基于完美的193浸没式系统或132nm干式系统。一旦考虑到SSL,DOF就会下降到“无PDS”曲线。包括PDS在内的DOF进一步下降。与132nm干式系统相比,这种损失对193nm浸液系统更有意义。性能较差的组与157nm系统有关,由于SSL和SSL PDS,两个阶段的DOF减少。一种典型的解释曲线的方法是,193nm沉浸式系统总比157nm干式系统好,杂散光用于杂散光。另一种看待它们的方式是在照明极化和SSL降低时改进的空间。表1列出了DOFdiff和DOFavail[12]的增益,对于32nm线,90和113nm间距的通常曝光-离焦(ED)窗,使用5%曝光宽容度的TE偏振照明,使用衰减相移掩模(AttPSM)和近轴环形照明(OAI)。还显示了DOFdiff保持恒定在200nm的曝光宽容度的增益。DOFdiff的增长率为23%,DOFavail的增长率为58%,曝光宽容度为47%。
DOFavail在65,45和32nm节点处的多晶硅层[3]如图12所示。DOFavail的要求如图所示为250,150和100nm。DOFdiff通过浸入式和偏振式兼容模拟[9]进行评估,使用在临界尺寸为65nm(CD)的180,225,270nm间距的共同E-D窗口;在130,163,195nm间距的45nmCD;在90,113,135nm间距的32nmCD。DOFavail是通过减去抗蚀剂厚度除以耦合介质的折射率得到的。在193nm干式系统中,DOFavail距AttPSM和OAI只有156nm。它在最理想的NA=0.925下增加到315nm。即使在稍低的NA=0.84下,DOFavail在286nm仍然可以接受。
对于45nm节点,使用AttPSM和OAI进行193nm浸没具有足够的DOFavail。TE照明更好。当谈到交替PSM(AltPSM),即使193nm干燥系统也符合DOFavail的要求。AttPSM和OAI的DOFavail可以通过降低第三个节距进一步提高,这代表了石印友好的设计。通过节距限制,即使是二元强度的掩模(BIM)也能提供足够的DOFavail。
32nm节点更加困难。只有AltPSM,极化和非极化,符合DOFavail要求。Att-PSM/OAI和跌落距离仍然不足。AltPSM和Drop-pitch极大地改进了DOFavail。请注意的是,AltPSM是用来表示一种强大的分辨率增强技术的,它不需要逐字解释。
2.2.3.亚波长3D掩模
当CD达到32nm时,其在掩模上的亚分辨率为0.663k,如图13所示。如果使用亚分辨率特征,掩模上的特征可小至0.166k。还有由光学接近校正(OPC)引起的亚分辨率夹具和水壶。这些3-D亚波长特征非线性地对照射做出反应,并且可能导致成像困难,更不用说制造包含非常小特征的掩模中的难题。因此,我们有动机去增加掩模的放大率。此外,由于NA变得非常大,透镜的尺寸,其材料和制造成本可能难以承受。这可以通过从已确定的26.33mm2的标准中减少镜头的大小来减轻。现场尺寸缩小和放大倍数增加相互补充,吸引了潜在的受益者。
唯一的问题是,由于较小的场地尺寸,曝光工具的生产率有所降低。花费在越过较小区域的时间增加,从而降低了曝光工具的晶片吞吐量。以前的工作[13]关于4至5倍掩模的生产力损失表明,4至5倍之间的成本差异约为10%。从4到8倍会更多。请注意,在由30-40个掩模层组成的整个半导体制造过程中,如果只有一个层具有需要较小字段大小的工具,则所有的其他工具必须重置其字段大小。工具上的价格节约可能在一层,但是生产力损失是在所有层面上的。因此,生产力损失是主导因素。不应增加掩模的放大倍数,除非物理定律禁止。
延迟物理定律限制的一种方法是使用如图14所示的固体浸没掩模。高指数透明材料在掩模上的3D吸收体结构上平坦化。这样,光照波长就会根据平坦化器的折射率降低。减少到70-80%是可能的。即使波长在光离开平坦化器后恢复,亚波长衍射区已经被处理好了。图14也显示了实验的改进。对于使用500nm厚平坦化器的180纳米节距多测试图案,掩模
全文共10793字,剩余内容已隐藏,支付完成后下载完整资料

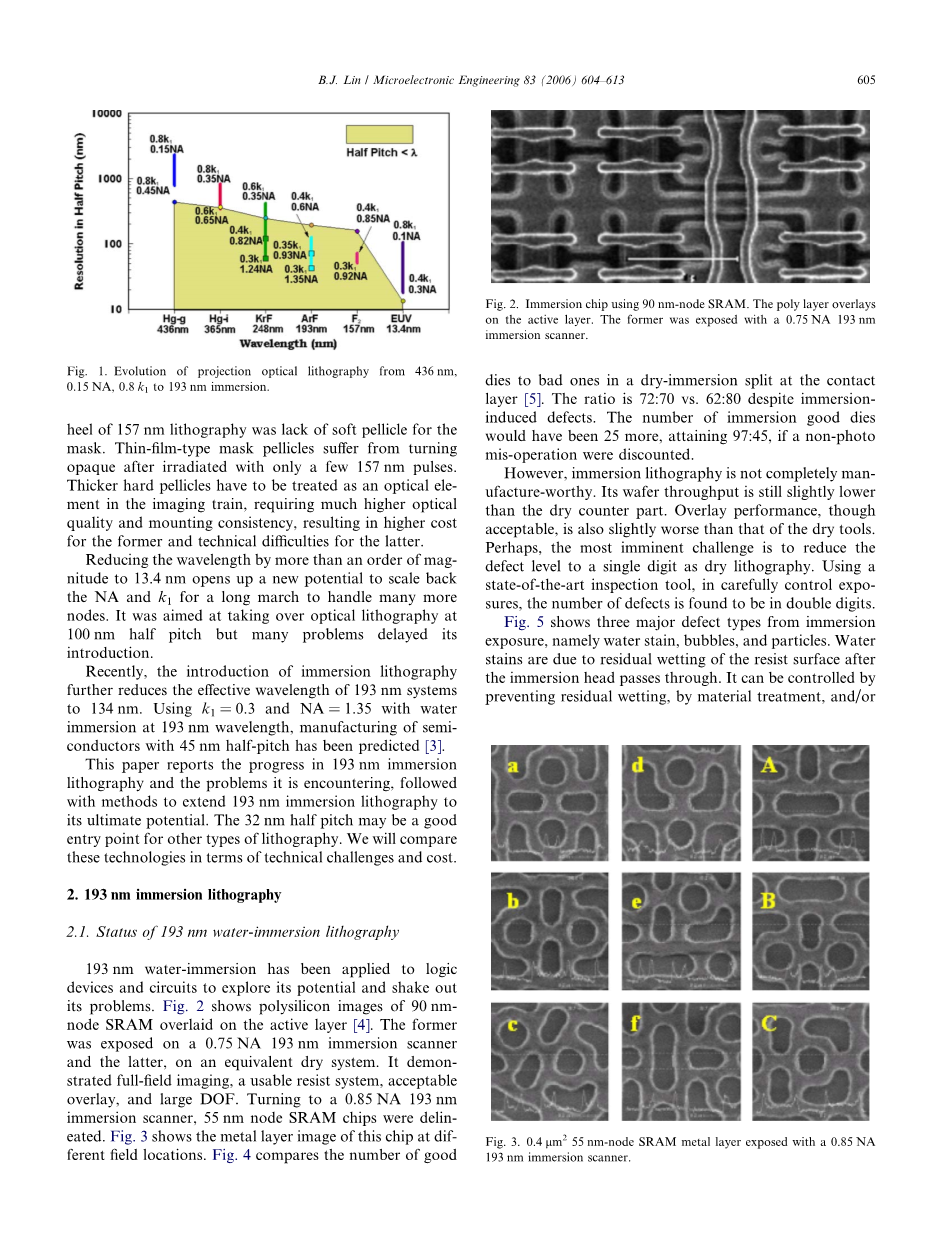
英语原文共 10 页,剩余内容已隐藏,支付完成后下载完整资料
资料编号:[9190],资料为PDF文档或Word文档,PDF文档可免费转换为Word


