
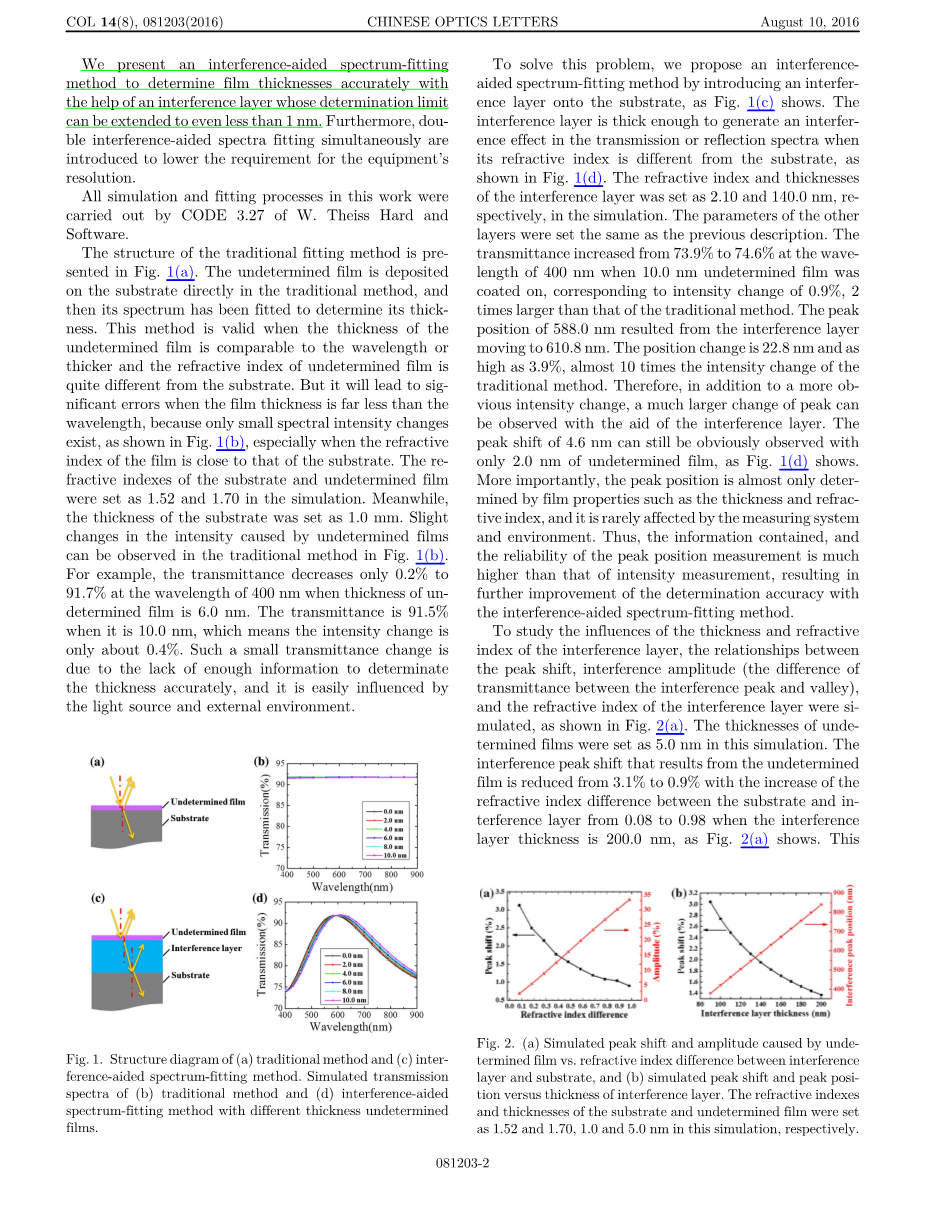
英语原文共 5 页
干涉辅助光谱拟合法用于薄膜厚度的精确测定
提出了一种利用干涉层进行光谱拟合,精确确定薄膜厚度的新方法,特别适用于超薄薄膜。测定限可达1 nm以下。它的精度远高于传统方法。该测定方法经实验验证,与原子力显微镜(AFM)测定结果相比,测定限至少为3.5 nm。提出了一种双干涉辅助光谱拟合方法,降低了测定仪器的要求,从而使用低精度的普通光谱仪测定薄膜厚度,大大降低了成本。它是一种非常高精度的现场和现场应用的测定方法,特别是对超薄薄膜。
目前,超薄膜在光学和电子器件中得到了广泛的应用。在金属氧化物半导体(MOS)技术[1]中,小于5.0 nm厚度的栅介电膜越来越普遍。10.0nm掺杂铝的氧化锌(AZO)薄膜在低e玻璃[2]中起着重要作用。由于单层和多层二氧化硅具有广阔的应用前景,对其光电特性进行了深入的研究。均匀性分析有助于制备大尺寸纳米薄膜[4]。这对光学薄膜的研究尤为重要,并将在很大程度上影响薄膜的光学性能。因此,超薄薄膜厚度的确定,特别是在沉积过程中的测量和控制,在工业和研究领域都具有重要意义。现场测厚主要有三种方法:石英晶体振荡法[5]、椭偏法[6]和光度法[7,8]。
石英晶体振荡法是一种良好的物理厚度监测方法,只有在涂层参数稳定、质量载荷小的情况下才适用。当工艺参数出现波动时,它不是一种精确的薄膜监测方法。此外,石英晶体振荡法不能监测薄膜的光学厚度,也不能控制薄膜的光学性能。为了准确监测光学厚度,提出了椭圆测厚法和光度法。前者对薄膜厚度变化非常敏感,是测量超薄膜[9]厚度的理想选择。但椭圆偏振测量系统结构复杂,不能使用光纤来保证偏振特性,增加了现场应用的难度和成本。光度光谱法是目前检测和监测薄膜厚度的主要原位方法[10]。
光度法是一种单波长监测方法,突出当膜厚度堪比lambda;/4或更厚,lambda;是监控波长。对于光度光谱(透射或反射光谱),利用传输矩阵法[11]可以方便地从光学常数和材料厚度计算光谱曲线。利用遗传算法[12]和退火算法[13]可以拟合出光学常数和厚度。前人花了大量的时间建立了光学常数的[14]模型,并对算法进行了优化。这些努力大大提高了厚度和指数测量的准确性。
然而,厚度的标定精度不仅受拟合过程的影响,还受光谱所包含信息量的大小所决定,且受光谱获取过程的精度影响显著。当薄膜厚度非常薄(一般小于90nm)时,有无薄膜的光谱变化非常小,不存在明显的特征光谱结构信息,导致拟合和准确测定困难。此外,当薄膜的折射率接近衬底时,几乎不可能分辨出薄膜。因此,对于90nm以下的薄膜,没有合适的方法进行准确的原位测厚。
我们提出了一种干涉辅助光谱拟合方法,利用干涉层可以将测定限扩展到小于1纳米,从而精确地测定薄膜厚度。同时引入双干涉辅助光谱拟合技术,降低了对仪器分辨率的要求。
本工作中所有的仿真和拟合过程均采用W. Theiss软件3.27进行。
传统拟合方法的结构如图1(a)所示。用传统的方法将待测薄膜直接沉积在基体上,然后用光谱法拟合待测薄膜的厚度。当待定薄膜的厚度与波长或厚度相当,且薄膜的折射率与衬底相差较大时,该方法是有效的。但是,当薄膜厚度远远小于波长时,会产生较大的误差,因为只有很小的光谱强度变化,如图1(b)所示,尤其是当薄膜折射率接近衬底折射率时。在模拟中,衬底和待定薄膜的折射率分别设置为1.52和1.70。同时,将衬底厚度设置为1.0mm。图1(b)中的传统方法可以观察到未确定薄膜引起的光强的轻微变化。例如,当待测薄膜厚度为6.0 nm时,在400 nm波长下,透射率仅下降0.2%至91.7%。当透射率为10.0 nm时,透射率为91.5%,说明光强变化仅为0.4%左右。这样小的透光率变化是由于缺乏足够的信息来精确地确定厚度,容易受到光源和外部环境的影响。
图1所示。(a)传统方法与(c)干涉辅助频谱拟合方法结构图。(b)传统方法和(d)不同厚度待定薄膜干涉辅助光谱拟合方法的模拟透射光谱。
为了解决这一问题,我们提出了一种干涉辅助光谱拟合方法,在基板上引入干涉层,如图1(c)所示。当干涉层的折射率与衬底不同时,干涉层的厚度足以在透射或反射光谱中产生干涉效应,如图1(d)所示。在模拟中,干涉层的折射率和厚度分别设置为2.10nm和140.0nm。其他层的参数设置与前面描述的相同。涂上10.0nm待定膜后,在400nm波长下透射率由73.9%提高到74.6%,对应的强度变化为0.9%,是传统方法的2倍。干涉层向610.8 nm移动,导致峰值位置为588.0 nm。位置变化为22.8 nm,高达3.9%,几乎是传统方法强度变化的10倍。因此,除了更明显的强度变化外,在干涉层的帮助下,峰值的变化可以观察到更大的变化。图1(d)所示,只有2.0nm的待定膜仍能明显观察到4.6nm的峰移。更重要的是,峰值位置几乎只由薄膜的厚度、折射率等性质决定,很少受到测量系统和环境的影响。因此,所包含的信息和峰位置测量的可靠性远高于强度测量,从而进一步提高了干涉辅助光谱拟合法的测定精度。
为了研究干涉层厚度和折射率的影响,模拟了干涉层的峰值位移、干涉幅值(干涉峰谷透过率差)与折射率之间的关系,如图2(a)所示。在本模拟中,未确定薄膜的厚度设置为5.0nm。当干涉层厚度为200.0nm时,随着衬底与干涉层折射率差由0.08增大到0.98,未确定薄膜的干涉峰位移由3.1%减小到0.9%,如图2(a)所示。
图2所示。(a)干涉层与衬底的折射率差与未确定薄膜引起的模拟峰移和振幅,(b)干涉层厚度与模拟峰移和峰位。在本模拟中,衬底和待定膜的折射率和厚度分别设置为1.52和1.70、1.0和5.0 nm。
这将降低厚度的测定精度。但干涉幅值会随着折射率差的增大而增大,这有利于提高测量精度。因此,应选择合适的干涉层折射率来平衡峰值位移和干涉幅值。虽然理论上折射率差可以自由变化,但实验中候选材料是有限的。Al2O3、Si3N4、Nb2O5、Ta2O5、TiO2是常用的弱吸收材料,可以作为干涉层。Nb2O5、Ta2O5和TiO2是很容易得到的高折射率材料。
研究了干涉层折射率为2.10时,干涉层的峰值位移和峰值位置与干涉层厚度的关系,如图2(b)所示。当干涉层厚度小于90nm时,可见波段无干涉峰。随着干涉层厚度从90 nm增加到200 nm,干涉峰位置从378 nm增加到840 nm。同时,待定膜引起的干涉峰位置偏移从3.0%下降到1.4%。此外,还应考虑探测器对分光计的灵敏度和适当的干涉峰位置。CCD或CMOS探测器通常在400~1100nm波段响应,峰值响应在600~800nm[15]之间。因此,当干涉层厚度为140nm左右时,在600 nm左右的波长处,其干涉峰位置更容易确定。
为了更实际地研究该方法,传统方法和干涉辅助频谱拟合方法都考虑了实验级随机噪声。在实验水平上,将光谱的信噪比(SNR)设置为1000∶1。同时,本仿真将干涉层厚度设为140nm。超薄膜厚度测定结果如表1所示。
为了更实际地研究该方法,传统方法和干涉辅助频谱拟合方法都考虑了实验级随机噪声。在实验水平上,将光谱的信噪比(SNR)设置为1000∶1。同时,本仿真将干涉层厚度设为140nm。超薄膜厚度测定结果如表1所示。
表1.计算结果与传统方法比较,信噪比为1000∶1
确定极限定义为误差小于20%时可确定的最小厚度。对于nupsilon;(待定薄膜折射率)= 2.10,用传统方法测定dupsilon;(待定薄膜厚度)在10.0 nm以上有效,误差为11%。当待定膜厚度为7.0 nm或更薄时,传统方法是完全无效的。因此,在这种情况下,传统方法的测定限理论上约为10.0nm。但当待测薄膜折射率为2.10时,本方法的测定极限可达到1.0nm甚至更薄。同样,当待定薄膜折射率降至1.70时,我们的方法的测定极限为2.0nm,而传统方法的测定极限为15.0nm。特别是当待定薄膜的折射率与衬底折射率相同时,nupsilon;=1.52,传统方法完全无法测量超薄膜厚度。但仍可采用干涉辅助光谱拟合法进行测定,测定限可达3.0nm。因此,与传统方法相比,该方法的测定限有了较大的提高。这是一个很好的方法来确定超薄膜厚度在现场作业。这一改进得益于引入的干涉层。
该方法在原理上对反射光谱拟合也是有效的。但由于反射光谱是一种间接测量,受入射角、参考镜等诸多因素的影响,其精度和可靠性均低于透射光谱。因此,它只用于传输无效或非常难以实现的情况,例如使用不透明的基片或无法获得传输信号的系统。
在上述理论分析的基础上,干涉层辅助光谱拟合法是一种精确确定薄膜厚度的有前途的方法。然后确定厚度的程序如下:干涉层涂覆基板的透射光谱以分光计作为标准参考。通过将待测薄膜涂覆在干涉层上前后的透射光谱进行拟合,可以得到未测薄膜的厚度。
为验证该方法的有效性,以Leybold ARES1110高真空镀膜系统为标准件沉积了一批Nb2O5和TiO2干涉层。这个过程类似于Ref.[15]。采用亚∕Nb2O5和Si(0 0 1)为底物,同时沉积不同厚度的SiO2作为待定膜,形成SiO2的台阶,用原子力显微镜(AFM)进行测量。
采用分光光度法测定了样品在可见光波段和近红外波段的透射光谱。采用DI多模扫描探针显微镜和IV控制器测量二氧化硅的厚度。
对于远离[16]吸收带的介质材料,采用指数吸收的柯西模型是有效的。公式是
利用该材料模型拟合了这些样品上Nb2O5和SiO2薄膜的光谱,以描述它们的光学常数。通过对每个样品的光谱进行拟合,可以直接得到待定薄膜的厚度和折射率。图3(a)给出了沉积在K9玻璃上的Nb2O5干涉层的测量值(950)和拟合透射光谱。Nb2O5的厚度为148.9nm。在600纳米波长下,其折射率约为2.28。图3(b)-3 (f)所示,待测SiO2薄膜不同厚度样品的光谱均很好地拟合。通过拟合,待定膜厚分别为3.1、5.6、7.8、11.1和16.5 nm。这些结果与3.5、5.4、7.3、11.8、15.8nm的AFM结果非常吻合,如图3(b)-3(f)所示。因此,干涉辅助光谱拟合法可以快速、准确地测定未测定薄膜的厚度,甚至在3.5nm范围内也可以。干涉层的引入克服了传统的通过透射或反射光谱拟合方法的缺点。
干涉辅助光谱拟合方法可以精确地确定薄膜的厚度,特别是对超薄薄膜,但由于其对强度值的依赖性较强,需要高精度光谱仪来保证测量结果。该方法可用于高精度光谱仪的原位检测。但这是昂贵的,大多数在线光谱系统没有这么高的精度。为了将该方法推广到现场操作中,需要降低对分光计精度的要求
图3所示.(a)用Lambda 950测量(取)K9玻璃上沉积的干涉层Nb2O5的透射光谱并进行拟合;采用Lambda 950对干涉层上的(b) 3.5、(c) 5.4、(d) 7.3、(e) 11.8和(f) 15.8nm超薄膜进行了测量,得到了拟合的透射光谱和AFM结果。
上述研究表明,当干涉层折射率不同时,峰值位移也不同,如图4(a)和图4(b)所示。因此,如果同时使用两个不同的干涉层,可以获得更多的信息。在这种情况下,只有两个未知数nupsilon;和dupsilon;,具有两个独立的光谱,如图4(a)所示。它们可以执行两个独立的方程,原则上nupsilon;和dupsilon;可以分别求解。将两种不同干涉层同时产生的实际光谱进行拟合,可以进一步增加信息量,在一定程度上降低对光谱仪的要求。
图4。(a)干涉层n=1.9和2.1的透射光谱和双干涉辅助光谱拟合方法的结构图;(b)干涉层n=1.9和2.1上未确定薄膜的峰移与厚度。
表2.用不同方法对超薄薄膜厚度进行了实验测定
参考文献
1. F. Schwierz, Nat.Nanotechnol.5, 487(2010).
2. E. Ando and M. Miyazaki, Thin Solid Films 351, 308 (1999).
3. C. Chen, H. Qiao, Y. Xue, W. Yu, J. Song, Y. Lu, S. Li, and Q. Bao, Photon. Res. 3, 110 (2015).
4. J. Hu, Q. Li, X. Lin, Y. Liu, J. Long, L. Wang, and H. Tang, Chin. Opt. Lett. 12, 072201 (2014).
5. C. S. Lu and O. Lewis, J. Appl. Phys. 43, 4385 (1972).
6. J. D. Klein, A. Yen, and S. F. Cogan, J. Appl. Phys. 68, 1825 (1990).
7. J. Kucirek, Czech. J. Phys. B 19, 537 (1969).
8. C. Qiu, X. Sun, and M. Luan, Chin. Opt. Lett. 11, 07


