
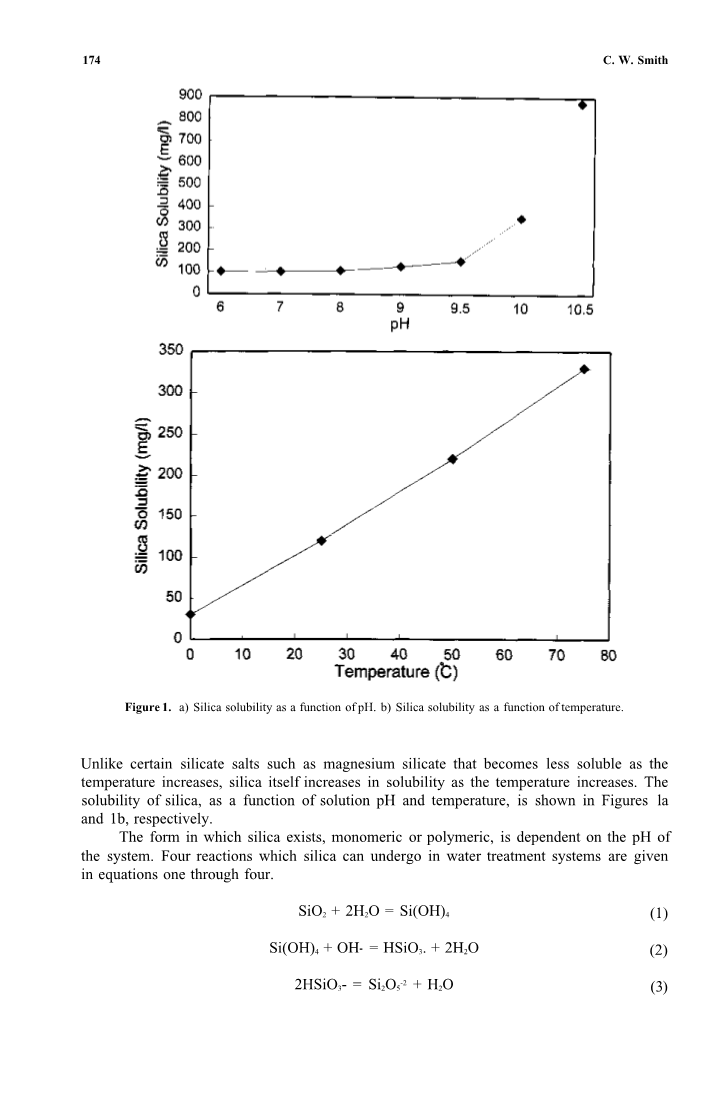
英语原文共 10 页,剩余内容已隐藏,支付完成后下载完整资料
采用高分子分散剂控制二氧化硅类垢的实验结果 Charles W. Smith
Mitco Water Laboratories, Inc.
Post Office Box 1699
Winter Haven, Florida 33882-1699
- 摘要
含有高浓度二氧化硅的水可以导致某些水处理系统严重结垢。在某些情况下,高含量的硅可能成为反渗透系统修复的限制条件。目前使用的聚合物阻垢剂导致了硅(以二氧化硅形式存在)含量远远超过了公认的最大含量,即150ppm。本文论述了在反渗透系统中使用两种聚合物阻垢剂防止硅沉积的实验结果。
2. 化学硅
硅是在自然界中发现的最丰富的元素之一。因此,它存在许多形式并不奇怪。反渗透进水中发现三种最常见的形式是单体硅,聚合态硅和硅酸盐。单体二氧化硅,硅酸盐,(Si(OH)4)通常被描述为“溶解”或“反应性”的二氧化硅。这种形式的硅可以与钼酸盐发生特征杂多蓝反应,可用于分析测试。聚合硅在水处理系统中遇到的最常见的两种形式是细胞和胶体。硅酸盐是由单体硅或者聚合态硅与各种阳离子沉积形成的,其中最常见的是镁离子[1-3]。
水系统中二氧化硅的溶解度取决于几个因素,包括pH值、温度、其他离子及硅的存在形式。其溶解度随pH的增大而增加,pH为6时溶解度为120ppm,pH为9时溶解度为140ppm。温度对二氧化硅溶解度的影响取决于其存在形式。
图1. a) pH对二氧化硅溶解度的影响 b) 温度对二氧化硅溶解度的影响
不像某些硅酸盐如硅酸镁,溶解度随温度的升高而降低,二氧化硅本身的溶解度随温度升高而增大。二氧化硅溶解度与pH及温度的关系分别如图1的a)和b)所示。
二氧化硅以单体或者聚合物存在取决于系统的pH值。二氧化硅在水处理系统中可能会发生的四个反应如下表所示:
|
SiO2 2H2O = Si(OH)4 |
(1) |
|
Si(OH)4 OH- = HSiO3. 2H2O |
(2) |
|
2HSiO3- = Si2O5-2 H2O |
(3) |
|
HSiO3- OH- = SO3–2 H2O |
(4) |
由所列的方程(1)到(4)可知,当pH由6变为9时,二氧化硅会发生一个聚合反应。第一步是形成硅酸,在第2个方程和第3个方程中,硅酸通过单体硅酸阴离子 (HSiO3-)形成中间体转化为二聚硅酸阴离子(Si2O5–2)。一二聚据硅酸盐阴离子形成,它能迅速地进行下一步的聚合反应,导致硅矿床的形成。另外,硅酸氢根离子能与氢氧根离子(OH -)反应,形成硅酸根离子,如方程(4)所示,而硅酸根离子可以很容易地与各种阳离子反应,形成硅酸盐沉淀[4-6]。
3.二氧化硅产生的问题
水处理系统容易出现许多矿床类型。不幸的是,沉积往往形成在最重要的设备领域。这会抑制传热、限制水流量、使膜表面结垢,以至于最终不得不关闭设备进行清洗。严重的沉积也会导致过热和高温设备故障。
一些在水处理系统中遇到的最困难的是那些二氧化硅沉积。如前所述,二氧化硅有几种不同的存在形式,每种形式都有自己独特的矿床类型。最终的沉淀类型取决于几个因素,包括pH值、温度、氧化硅的类型,和其他离子系统。几个硅垢的形成机制已在文献中如硅酸盐阴离子单体或各种离子聚合硅酸反应报道。另一种机制涉及聚合对硅酸导致非晶硅矿床的形成[7]。
硅酸镁(MgSiO3)是一个比较麻烦的硅垢。它会形成一种密集态,因此很难去除的。硅酸镁沉淀的形成在很大程度上取决于溶液的pH值和温度。当RO系统运行在pH值为9时,由于存在氧化镁和硅酸根离子,很容易形成硅酸镁。虽然通常被称为MgSiO3、硅酸镁被认为是水处理系统中由于产生了包含镁和二氧化硅的各种化学混合物而形成的,是一个多步骤的过程。第一步是形成氢氧化镁(Mg(OH)2),氢盐硅酸盐阴离子单体和/或聚合硅形成硅酸镁反应。其他如氢盐的钙、锶、钾、钠也能够与二氧化硅发生反应,但是产物的溶解度更大,因此不太可能形成沉积膜。
水处理系统中常遇到的另一种类型的二氧化硅类垢物是二氧化硅或无定形聚合物。与硅酸镁不同,二氧化硅聚合物在水中的溶解度随温度的升高而增加,因此,因此,它往往会沉淀在温度最低的RO系统区域。非晶硅沉积的两种主要类型有胶体和细胞。聚合硅垢特别容易通过膜表面和反渗透系统的进水通道间隔。在反渗透系统,鉴于废品率一般大于90%,超过150 ppmSiO2水平的高硅料水很容易得到。此外,一旦形成,这些沉积物很容易与少量的阳离子,如钙、铁、铝、镁形成类垢物。
- 硅阻垢剂
二氧化硅类垢物一旦形成就很难去掉。目前已经开发了许多方法避免硅沉积的形成[8-9]。一个最简单的方法是保持其组成如硅和镁的浓度低于形成沉淀所需的最低浓度。水处理系统中最常见的pH范围是在6至9,这意味着硅水平必须保持低于150 ppm。此外,如果有镁存在,其所形成的产物MgCO3和二氧化硅(SiO2)含量不应超过20000 ppm。
各种化学处理方案已经制定,这些方案允许比上面列举的更高水平的硅或镁保持在水处理系统中[6,10-15]。这些项目中的大多数依靠分散剂使二氧化硅粒子在一个足够小的大小排除沉积。聚合物由于具有很多性能例如其分散性,已成功在工业水处理中使用了多年。作为分散剂的聚合物通常是阴离子,其分子量分子量范围从一到二万。阴离子型高分子分散剂通过与分散的粒子结合形成带负电荷的离子群而起作用。在过去使用的阴离子聚合物中,成功保持分散性的粒子包括碳酸盐、硫酸盐和磷酸盐。
扩大聚合物在分散二氧化硅颗粒和/或减少二氧化硅聚合的使用方面已经做了大量的研究工作[16-21]。由于大多数类垢物含有非晶硅的二氧化硅和/或硅酸镁,理想的分散剂必须有两种截然不同的性质。它必须能够在二氧化硅颗粒和硅酸镁颗粒成为能够形成类垢物的大小前将它们分散。此外,它还必须能够分散粒子例如碳酸钙,它可以作为二氧化硅类垢物形成的核。另一个喜一种高分子硅阻垢效果理想的功能会减少或控制硅聚合的影响。聚合物型硅阻垢剂的另一种理想性质是可以减少或者控制硅发生聚合反应对其的影响。
众多的研究小组已经对具有这些性能的聚合物进行了测试,包括我们小组。对两种非常有前景的特殊聚合物进行现场测试的实验结果将会作出进一步讨论。
- 实验
本研究所运行的试点RO系统包含一个螺旋缠绕、聚酰胺、2.5”40膜、Filmtec公司制造的模型。通过加入酸来控制浓缩流的pH值。当二氧化硅的平均浓度在持续的测试时间内达到500ppm时,给水开始循环。这是通过保持的渗透和集中的流量恒定,同时监测系统的压力来实现的。所有报道的实验结果是基于100%活性抑制剂的基础,这些结果将会用于相互比较。
如果在恒流量时膜的进料压力增加了10%以上,那么可以确定膜已被硅垢污染。如果压力没有下降,那么进料水中已经投入了足够量的聚合物阻垢剂来防止硅垢的形成。我们使用了一个创建标准化的渗透流量与时间图的软件程序。在已经形成硅垢的测试中,归一化的渗透流比典型的测试至少下降了10%,而在成功的测试运行中则无明显下降。
被硅垢污染的膜使用2%氟氢化铵/盐酸溶液清洗。清洗时将膜隔离大约230分钟,然后由水冲洗至少10至15分钟。注意:清洗过程必须十分小心,因为此过程产生的氢氟酸溶液对皮肤有极强的腐蚀性。
- 结果
结合台式筛选测试结果,聚合物产商的分析以及先前的调查结果,我们选择了A和B[22]两种商用聚合物进行此次RO试验。两个厂家分别将这两种聚合物作为阻垢剂。我们做了大量的测试,在聚合物A和B中添加的二氧化硅比例从0到120。在不添加聚合物的试验中,RO膜在几个小时内形成了硅垢,很明显比维持恒定水流所需的给予的压力增加了10%以上。饲料中的压力必须保持恒定的FL增加明显大于10%流量。在这些测试中,当pH值在7.25左右时,二氧化硅的浓度会达到530ppm。这些“控制”试验证明,在我们所给定的实验条件下,二氧化硅的确会在膜上结垢。
使用硅活性聚合物的比例逐渐增加两聚合物阻垢剂得到了比较试验。最初的测试是在每ppm活性聚合物A中添加7.5ppm的二氧化硅,这时RO膜没有结垢。反渗透浓缩流的平均朗丽尔饱和指数(LSI)为1.26,pH值为7.30,二氧化硅的平均浓度为524ppm。我们将在导致膜结垢的更高的比例下进行试验。
使用聚合物B时,聚合物/二氧化硅提高到120,但是并未出现任何结垢现象。当二氧化硅的平均浓度为556ppm时,RO浓缩液流的LSI平均值为1.73,pH值为7.10。试验的一些测试结果总结如表一所示。
基于以上结果,我们决定使用新的“处女膜”重复之前的两个测试这些膜可以用于尸检和结垢分析。之前硅水浓缩的RO中二氧化硅的含量显著过饱和(超过500ppm)。试验中的自然水被重复使用,以用来保证实验结果的相似性,以及直接应用于实际情况。RO系统中经典的浓缩流样品元素分析如表二。试点单位配备了陶氏FILMTEC FT30膜和被设计在一个媲美全尺寸的操作单元。试点单位开始没有任何抑制剂,直到时间为日单位开始结垢。标准化的渗透流数据(图2)显示,在这些加速条件下,膜开始在几个小时内开始结垢。当归一化的渗透流量损失26%时系统被关闭,然后膜被移除用来做详细的结垢分析。
重新安装膜后,使用聚合物B重启操作单元。在浓缩流中调整聚合物B的剂量使得每120ppm的二氧化硅含有1ppm的活性抑制剂。当实验单元运行相同的时间后停止试验,使膜可以直接用于比较。该系统的归一化渗透流数据显示膜无明显的结垢现象(表三)。
两膜被送回实验室进行分解和污垢的分析。对照膜(无抑制剂)被完全包覆有一种可通过触摸去除的轻质粉状物质。代表性的膜样本被分解用于基础分析。图四是膜的电子显微图像。虽然图五所示的用能量色散X射线测定的结果表明这种材料中含有多价离子的混合物,但其主要成分是二氧化硅。结垢物的元素分析表明,对照膜的二氧化硅峰(图五)为主要的峰。
试验所用的加入二氧化硅抑制剂聚合物B的膜被分解。膜叶显示没有可见的污垢的迹象(即,外观为处女膜)。刮膜时没有任何材料落下,摩擦表面也没有任何粉状物料脱落。对膜样品进行拍摄并提交分析。图6是在精矿端膜表面的显微照片。该区域的能谱仪(图7)显示低水平的硅垢物。然而,对含有聚合物B膜(图7)的试验分析发现,与用聚砜支撑材料硫峰相比,该膜的二氧化硅含量低得多。
|
表一. |
实验结果总结 |
||||
|
聚合物 |
加入聚合物的量 |
加入二氧化硅的量 |
二氧化硅/聚合物 |
二氧化硅浓度 |
膜是否被污染 |
|
None |
0 |
110 |
– |
525 |
是 |
|
A |
16.8 |
128 |
7.6 |
476 |
否 |
|
A |
2.83 |
102 |
36 |
531 |
否 |
|
A |
1.94 |
107 剩余内容已隐藏,支付完成后下载完整资料 资料编号:[147992],资料为PDF文档或Word文档,PDF文档可免费转换为Word |
|||
您可能感兴趣的文章
- 可调聚合物微球的简易合成及其在包裹色料中的应用研究外文翻译资料
- 非均质表面结构的金属有机框架用于癌症治疗,成像和生物传感的研究进展外文翻译资料
- 金属氧化物光阳极电荷产生到光催化的动力学综述外文翻译资料
- ILs基凝胶在储能、传感器和抗菌方面的研究进展外文翻译资料
- 水凝胶在水体污染物吸附和废水处理中的应用外文翻译资料
- 半互穿壳聚糖/离子液体聚合物网络作为伤口敷料和离子电渗透材料的应用研究外文翻译资料
- 碳纳米管/PLA复合材料的增材制造及构效关系外文翻译资料
- 单宁酸诱导环氧化大豆油交联增韧聚乳酸外文翻译资料
- 新型偶氮苯基两亲性共聚物:合成、自组装行为和多刺激响应特性外文翻译资料
- 用于多胺识别的光子晶体协同传感器芯片外文翻译资料


